IBM и Micron Technology объявили о намерении серийно выпускать новую память, для изготовления которой впервые будет применена технология CMOS с межслойными соединениями (through-silicon via, TSV). Речь идет о памяти под названием Hybrid Memory Cube (HMC), представленной в сентябре на конференции Intel для разработчиков. Память разработана Micron и Intel совместно. В свою очередь, компания IBM является разработчиком технологии TSV. О подробностях технологии TSV компания IBM расскажет 5 декабря на мероприятии IEEE International Electron Devices Meeting.
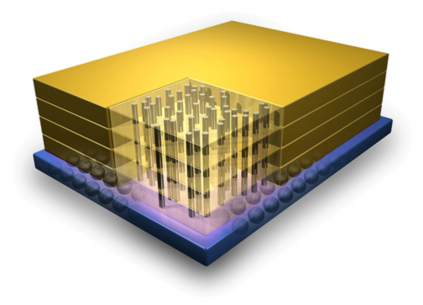
Компоненты HMC будет выпускать передовая фабрика IBM, расположенная в штате Нью-Йорк. При этом будет использоваться 32-нанометровый техпроцесс HKMG.
В памяти HMC межслойные соединения служат для электрической связи между собранными в стопку кристаллами DRAM и кристаллом со схемой высокоскоростного ввода-вывода. Такая компоновка обеспечивает существенный прирост производительности при одновременном снижении габаритов и энергопотребления подсистемы памяти по сравнению с существующими решениями. Прототипы HMC показали, что пропускная способность увеличивается в 10 раз, а энергопотребление сокращается на 70%. При этом HMC занимает всего 10% площади печатной платы, занимаемой обычными микросхемами DRAM того же объема.
В октябре компании Micron и Samsung сформировали консорциум Hybrid Memory Cube Consortium (HMCC), задачей которого является разработка и продвижение открытой спецификации HMC.
Источник: Micron Technology
