Компания ASML завершила разработку пелликул, подходящих для фотолитографии в жёстком ультрафиолетовом диапазоне (EUV).
Пелликулами называются ультратонкие прозрачные мембраны для защиты фотошаблонов от попадания на них частиц, приводящих к появлению дефектов в чипах.
В отсутствие пелликул производителям, уже использующим EUV, приходилось мириться с потенциально низким выходом годной продукции и увеличением затрат на очистку масок и тестирование пластин.
Создание защитных плёнок, подходящих для EUV, потребовало много времени, поскольку предъявляемые к ним требования существенно отличаются от требований к плёнкам для предыдущего поколения фотолитографии. Однако, как только они появятся на рынке, ожидается, что все производители полупроводниковой продукции, осваивающие или уже использующие EUV, интегрируют их в свои техпроцессы. Это позволит повысить процент выхода годной продукции и снизить её стоимость.
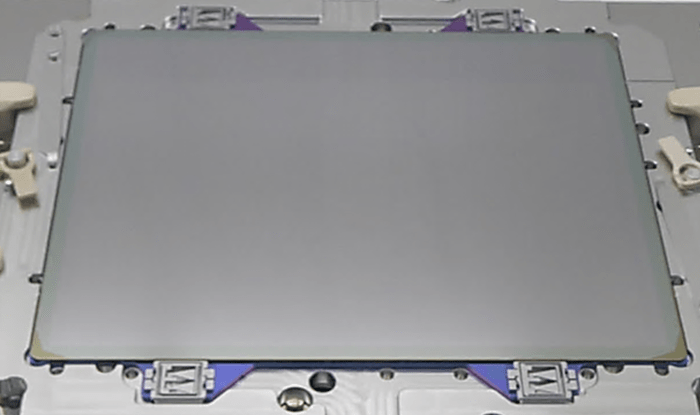
Уточним, что первые прототипы у ASML были готовы ещё в 2016 году, но они имели невысокое светопропускание (78%). В прошлом году этот показатель удалось довести до 88%. Последние образцы характеризуются светопропусканием 90,6%. Кроме того, удалось существенно уменьшить коэффициент отражения и увеличить равномерность слоя.
По данным источника, пелликулы для EUV-литографии планируют предложить и другие участники рынка, помимо ASML.


