Компания United Microelectronics Corporation (UMC), входящая в пятерку крупнейших контрактных производителей полупроводниковой продукции, объявила о начале серийного производства изделий с объемной компоновкой, в которых используется технология межслойных соединений Through-Silicon-Via (TSV).
Говоря более конкретно, эта технология используется в графических процессорах AMD Radeon R9 Fury X. С ее помощью на общей промежуточной подложке (объединительном кристалле) объединяются кристаллы собственно процессора и памяти HBM DRAM, что позволяет связать память с процессором 4096-разрядной шиной. В результате удается в четыре раза превзойти нынешнюю память GDDR5 по энергетической эффективности.
Промежуточные подложки TSV изготавливаются на предприятии Fab 12i, расположенном в Сингапуре и работающем с 300-миллиметроывми пластинами. Вопреки некоторым поверхностным представлениям, чипы GPU и памяти смонтированы не на общей печатной плате, а на кремниевом кристалле, где с помощью технологий CMOS и TSV сформированы необходимые дорожки и переходные отверстия. Кристаллы GPU и памяти контактируют с ним с помощью микроскопических шариковых выводов. А уже кристалл промежуточной подложки установлен на традиционную внешнюю подложку «корпуса» микросхемы, на обратной стороне которого находятся шариковые выводы BGA.
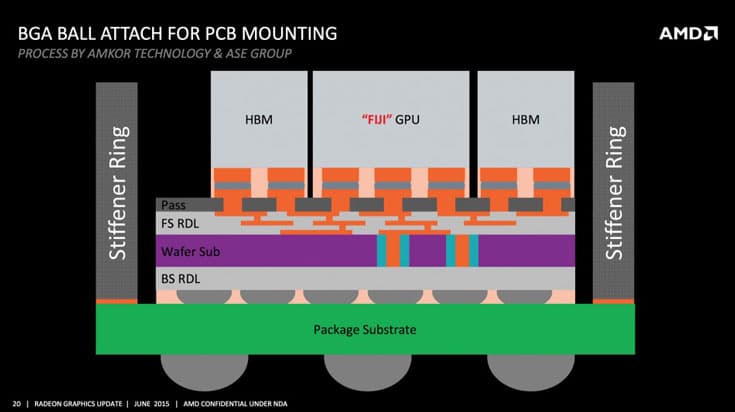
Источник: UMC





