Специалистам компаний Tokyo Electron и Novellus Systems удалось разработать технологию создания медных внутренних соединений в микросхемах, выпускаемых по нормам 2X нм и менее.
Особенностью технологии является формирование барьеров из нитрида тантала (TaN) или титана (Ti) и создание сверхтонкого направляющего слоя рутения (Ru) с применением процесса химического осаждения из газовой фазы.
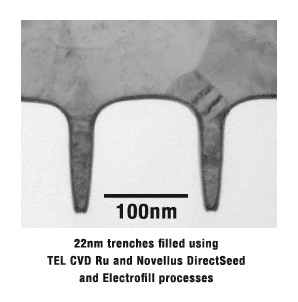
В разработке используется новая схема металлизации, состоящая из двух ключевых шагов.
Во-первых, это формирование химическим осаждением из газовой фазы прослойки из рутения. Прослойка характеризуется высокой конформностью (сохранением углов) и постоянством удельного сопротивления в сложных конфигурациях при толщине менее 2 нм. В серийном производстве стоимость этого процесса, включая вспомогательные этапы, по словам разработчиков, выглядит на фоне других вариантов весьма привлекательно.
Вторым ключевым шагом является процесс нанесения затравочного слоя меди, получивший название DirectSeed и выполняемый в электрохимической установке Novellus SABRE Extreme. Слой, формируемый непосредственно поверх слоя рутения, имеет высокую равномерность и толщину не более 3 нм. Применение этого процесса устраняет необходимость в формировании затравочного слоя меди химическим осаждением из газовой фазы, позволяя исключить из техпроцесса все связанные с этим этапы.
Источник: Tokyo Electron
